 박정호기사 모아보기, 곽노정닫기
박정호기사 모아보기, 곽노정닫기 곽노정기사 모아보기)가 세계 최초로 D램 단품 칩 12개를 수직 적층해 현존 최고 용량인 24GB를 구현한 HBM3 신제품을 개발했다고 20일 밝혔다.
곽노정기사 모아보기)가 세계 최초로 D램 단품 칩 12개를 수직 적층해 현존 최고 용량인 24GB를 구현한 HBM3 신제품을 개발했다고 20일 밝혔다. HBM은 여러 개의 D램을 수직으로 연결해 기존 D램보다 데이터 처리 속도를 혁신적으로 끌어올린 고부가가치, 고성능 제품이다. HBM은 1세대(HBM), 2세대(HBM2), 3세대(HBM2E), 4세대(HBM3) 순으로 개발돼 왔다. 기존 HBM3의 최대 용량은 D램 단품 칩 8개를 수직 적층한 16GB였다.
SK하이닉스가 2013년 세계 최초로 개발한 HBM은 고성능 컴퓨팅을 요구하는 생성형 AI에 필수적인 메모리 반도체 제품으로 업계의 주목을 받고 있다.
특히 HBM3는 대량의 데이터를 신속히 처리하는 데 최적의 메모리로 평가 받아 빅테크 기업들의 수요가 점차 늘고 있다.
SK하이닉스는 “지난해 6월 세계 최초로 HBM3를 양산한데 이어 이번에 기존 대비 용량을 505 높인 24GB 패키지 제품을 개발하는 데 성공했다”라며 “최근 AI 챗봇 산업이 확대되면서 늘어나고 있는 프리미엄 메모리 수요에 맞춰 하반기부터 시장에 신제품을 공급할 수 있을 것”이라고 강조했다.
SK하이닉스 기술진은 이번 제품에 어드밴스드 MR-MUF 기술을 통해 공정 효율성과 제품 성능 안정성을 강화했다.
MR-MUF 기술은 반도체 칩을 쌓아 올린 뒤 칩과 칩 사이 회로를 보호하기 위해 액체 형태의 보호재를 공간 사이에 주입하고, 굳히는 공정이다. 칩을 하나씩 쌓을 때마다 필름형 소재를 깔아주는 방식 대비 공정이 효율적이고, 열 방출에도 효과적인 공정으로 평가 받는다.
또 TSV 기술을 활용해 기존 대비 40% 얇은 D램 단품 칩 12개를 수직으로 쌓았다. 용량은 크지만 높이는 16GB 제품과 같다.
TSV 기술은 칩에 수천 개의 미세한 구멍을 뚫어 상층과 하층 칩의 구멍을 수직으로 관통하는 전극으로 연결하는 어드밴스드 패키징 기술이다. 이 기술이 적용된 SK하이닉스의 HBM3는 FHD(풀HD) 영화 163편을 1초에 전송하는, 최대 819GB/s의 속도를 구현한다.
SK하이닉스는 현재 다수의 글로벌 고객사에 HBM3 24GB 샘플을 제공해 성능 검증을 진행 중이다.
홍상후 SK하이닉스 부사장(P&T담당)은 “세계 최고의 후공정 기술력을 바탕으로 초고속, 고용량 HBM 제품을 연이어 개발해낼 수 있었다”며 “상반기 내 이번 신제품 양산 준비를 완료해 AI 시대 최첨단 D램 시장의 주도권을 확고히 해나가겠다”고 말했다.
정은경 기자 ek7869@fntimes.com










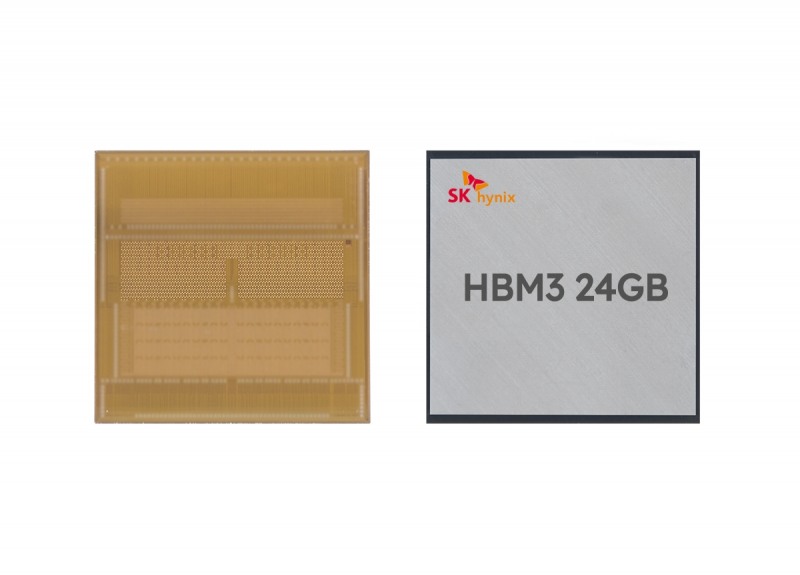
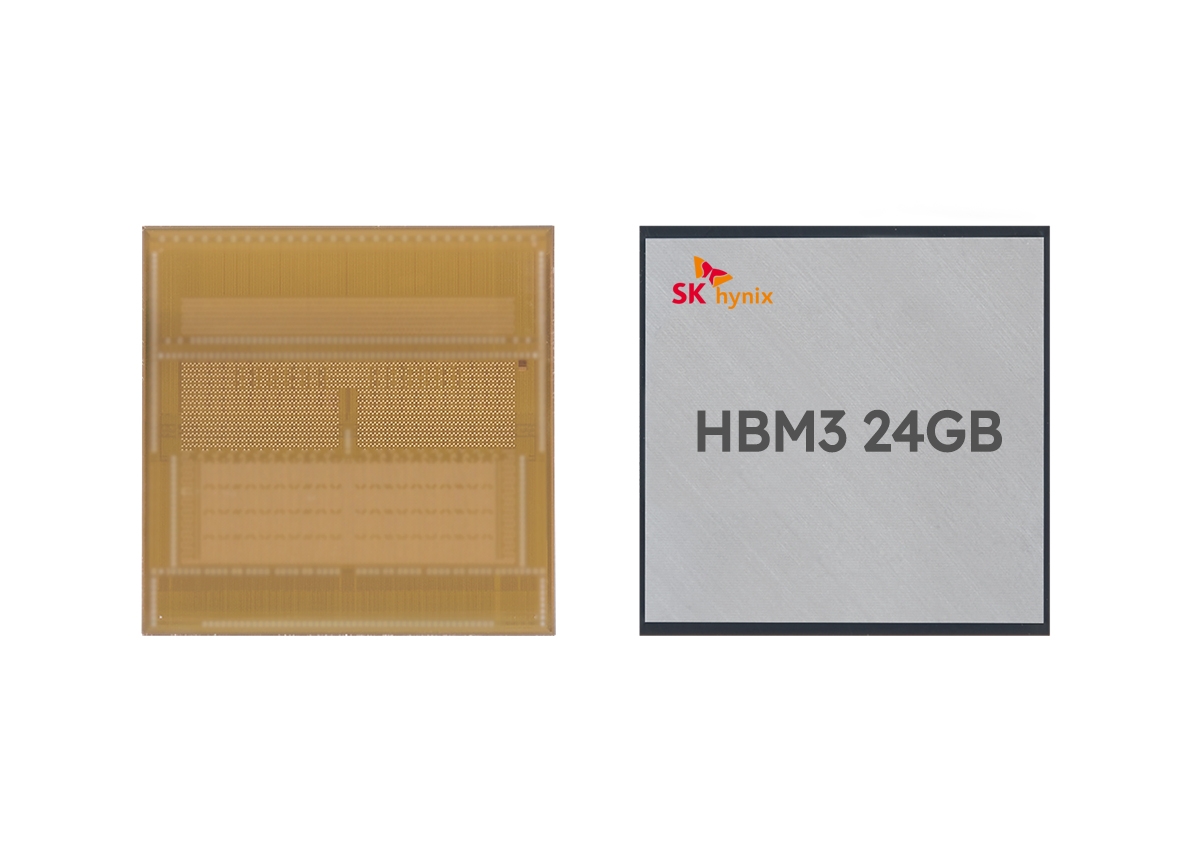















![스테이블코인 입법 '주춤'···한은, CBDC 실험 재개 ‘속도전’ [디지털자산 풍향계]](https://cfnimage.commutil.kr/phpwas/restmb_setimgmake.php?pp=006&w=69&h=45&m=5&simg=20260319211631031920b4a7c6999c121131189150.jpg&nmt=18)

!['스타 발굴 대가' 이수만도 10억 투자...드론 강자 '파블로항공' [K-방산 신흥강자 ②]](https://cfnimage.commutil.kr/phpwas/restmb_setimgmake.php?pp=006&w=69&h=45&m=5&simg=202603201423320542000d260cda7511817679169.jpg&nmt=18)



!['검증된 인물 우선' 국힘 서울시당, 서울 구청장 단수추천 속도전[6·3지방선거]](https://cfnimage.commutil.kr/phpwas/restmb_setimgmake.php?pp=006&w=69&h=45&m=5&simg=20260320173907030190b372994c951245313551.jpg&nmt=18)
![강기범 하나증권 디지털신사업실장 "초기 생태계 조성 미션…다양한 발행인 발굴" [증권사 디지털자산 상륙작전 ③]](https://cfnimage.commutil.kr/phpwas/restmb_setimgmake.php?pp=006&w=69&h=45&m=5&simg=202603191613170504300f4390e77d222112131237.jpg&nmt=18)
![[3월 4주 청약] 전국 청약 2237가구…서울 영등포 ‘더샵 프리엘라’ 1순위 청약](https://cfnimage.commutil.kr/phpwas/restmb_setimgmake.php?pp=006&w=69&h=45&m=5&simg=20260320160509080010048b7183331435245135.jpg&nmt=18)













![[그래픽 뉴스] “AI가 소프트웨어를 무너뜨린다? 사스포칼립스의 진실”](https://cfnimage.commutil.kr/phpwas/restmb_setimgmake.php?pp=006&w=298&h=298&m=1&simg=2026030416113601805de68fcbb3512411124362.jpg&nmt=18)
![[그래픽 뉴스] “돈로주의 & 먼로주의: 미국 외교정책이 경제·안보에 미치는 영향”](https://cfnimage.commutil.kr/phpwas/restmb_setimgmake.php?pp=006&w=298&h=298&m=1&simg=202602261105472649de68fcbb3512411124362_0.jpg&nmt=18)
![[그래픽 뉴스] 워킹맘이 바꾼 금융생활](https://cfnimage.commutil.kr/phpwas/restmb_setimgmake.php?pp=006&w=298&h=298&m=1&simg=202602021638156443de68fcbb3512411124362_0.jpg&nmt=18)
![[그래픽 뉴스] 매파·비둘기부터 올빼미·오리까지, 통화정책 성향 읽는 법](https://cfnimage.commutil.kr/phpwas/restmb_setimgmake.php?pp=006&w=298&h=298&m=1&simg=2026022714105702425de68fcbb3512411124362.jpg&nmt=18)
![[그래픽 뉴스] 하이퍼 인플레이션, 왜 월급이 종잇조각이 될까?](https://cfnimage.commutil.kr/phpwas/restmb_setimgmake.php?pp=006&w=298&h=298&m=1&simg=202601141153149784de68fcbb3512411124362_0.jpg&nmt=18)
![[신간] 고수의 M&A 바이블](https://cfnimage.commutil.kr/phpwas/restmb_setimgmake.php?pp=006&w=81&h=123&m=5&simg=2025091008414900330f8caa4a5ce12411124362.jpg&nmt=18)
![[신간] 리빌딩 코리아 - 피크 코리아 극복을 위한 생산성 주도 성장 전략](https://cfnimage.commutil.kr/phpwas/restmb_setimgmake.php?pp=006&w=81&h=123&m=5&simg=2025032814555807705f8caa4a5ce12411124362.jpg&nmt=18)
![[서평] 추세 매매의 대가들...추세추종 투자전략의 대가 14인 인터뷰](https://cfnimage.commutil.kr/phpwas/restmb_setimgmake.php?pp=006&w=81&h=123&m=5&simg=2023102410444004986c1c16452b0175114235199.jpg&nmt=18)


![[신간] 이게 화낼 일인가?](https://cfnimage.commutil.kr/phpwas/restmb_setimgmake.php?pp=006&w=81&h=123&m=5&simg=2026010610254801367f8caa4a5ce12411124362.jpg&nmt=18)

![[AD] 현대차, 글로벌 안전평가 최고등급 달성 기념 EV 특별 프로모션](https://cfnimage.commutil.kr/phpwas/restmb_setimgmake.php?pp=006&w=89&h=45&m=1&simg=20260106160647050337492587736121125197123.jpg&nmt=18)
![[AD] 현대차 ‘모베드’, CES 2026 로보틱스 부문 최고혁신상 수상](https://cfnimage.commutil.kr/phpwas/restmb_setimgmake.php?pp=006&w=89&h=45&m=1&simg=20260105103413003717492587736121125197123.jpg&nmt=18)
![[AD] 기아 ‘PV5’, 최대 적재중량 1회 충전 693km 주행 기네스 신기록](https://cfnimage.commutil.kr/phpwas/restmb_setimgmake.php?pp=006&w=89&h=45&m=1&simg=20251105115215067287492587736121125197123.jpg&nmt=18)
![[카드뉴스] KT&G, 제조 부문 명장 선발, 기술 리더 중심 본원적 경쟁력 강화](https://cfnimage.commutil.kr/phpwas/restmb_setimgmake.php?pp=006&w=89&h=45&m=1&simg=202509241142445913de68fcbb3512411124362_0.png&nmt=18)
![[AD]‘황금연휴에 즐기세요’ 기아, ‘미리 추석 페스타’ 이벤트 실시](https://cfnimage.commutil.kr/phpwas/restmb_setimgmake.php?pp=006&w=89&h=45&m=1&simg=20250903093618029117492587736121166140186.jpg&nmt=18)



